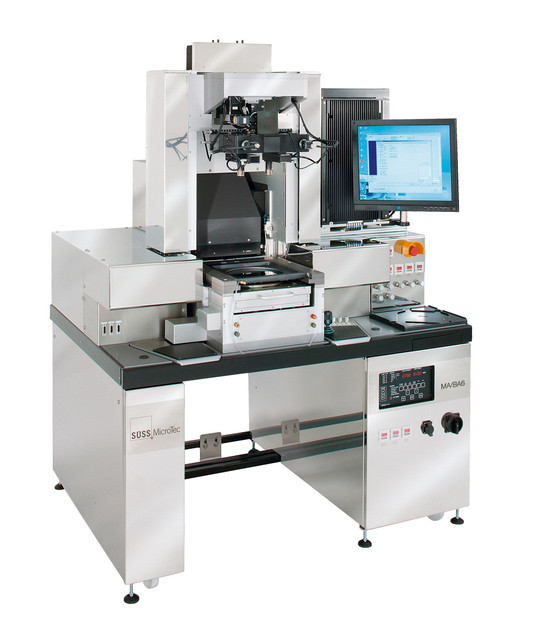
- Основные
- Производитель
- Страна производительГермания
Описание:
MA/BA6 Gen3 представляет собой инновационную установку совмещения, предназначенную для научно-исследовательской деятельности и производства. Она обеспечивает высокую гибкость процессов и предлагает новые характеристики и ключевые компоненты, такие как система управления на базе Windows, автоматическое совмещение или совмещение с подсказками и компенсация погрешности. Установку совмещения можно дополнительно оборудовать системой для импринт литографии (SMILE) для большой площади.
Система MA/BA6 Gen3 является отличным выбором для проведения литографии всей поверхности пластины для процессов в области МЭМС, 3D-интеграции и составных полупроводников.
Основные возможности:
- Оптика высокого разрешения (HR) позволяет формировать структуру с элементами размером менее 0.5 мкм
- Автоматическое совмещение и совмещение с участием оператора позволяет добиться точности до 0,25 мкм
- Расширенные автоматические функции для максимального контроля процесса
- Совместимость процессов с автоматическим оборудованием
- Оптимизированный микроскоп с двойным полем, прямым обзором и/или опцией ЖК-экрана
- Простое переключение в режим совмещения для сращивания
- Возможна модернизация до 8"
|
Решения MA/BA6 GEN3 |
|
|
|
|
|
|
|
Благодаря способности обрабатывать любые типы пластин и подложек, ручные установки совмещения все чаще используются в производственной среде. Новая установка совмещения и экспонирования MA/BA6 Gen3 отвечает постоянно растущим требованиям более жесткого контроля процесса и высокой производительности. Установка MA/BA6 Gen3 предназначена для быстрой и эффективной разработки новых технологий и изделий. Исследовательские организации выиграют от расширенных возможностей данной машины, поскольку она позволит разрабатывать необходимые процессы на оборудовании, выполненном в соответствии с отраслевыми стандартами. Система позволяет легко и экономично перенести процесс из лаборатории в производство. Возможна модернизация установки MA/BA6 Gen3 до 8".
Интегрированная функциональность
Помимо режима стандартной установки совмещения MA/BA6 Gen3 предлагает целый ряд функций, например нано-импринтинг, совмещение для сращивания и УФ-сращивание с возможностью быстрого переключения между ними.
Расширяем границы технологии
Не имеющая аналогов точность совмещения в сочетании с высоким разрешением и максимальной равномерностью подсветки делают MA/BA6 Gen3 оптимальным выбором для применения в различных областях - от МЭМС, оптоэлектроники и 3D-интеграции до микрооптики и нанотехнологий.

Наноимпринт-литография.
Отверстия шириной 160 нм, расположенные в форме концентрических колец, используются в фотонных кристаллах

Технические характеристики:
|
Шаблон и пластина/подложка |
|||
|
Размер пластины |
1'' - 150 мм |
||
|
Макс. размер подложки |
150 х 150 мм |
||
|
Мин. фрагментов |
5 х 5 мм |
||
|
Толщина пластины |
макс. 10 мм |
||
|
Размер шаблона |
стандарт 2'' х 2'' |
||
|
Режимы экспонирования |
|||
|
Контакт |
Мягкий, плотный, вакуум |
||
|
Зазор |
Зазор экспонирования 1-300 мм |
||
|
Точность настройки зазора |
1 мкм |
||
|
Вакуумный контакт |
Регулируется до - 80 кПа |
||
|
Режимы |
Постоянное питание, постоянная доза |
||
|
Опции |
Сплошное, ступенчатое экспонирование |
||
|
Экспонирующая оптика |
|||
|
Разрешение* |
|||
|
Режим экспонирования |
uV400 |
uV300 |
uV250 |
|
Вакуумный контакт |
1.5 мкм |
0.5 мкм |
0.4 мкм |
|
Плотный контакт |
2.0 мкм |
1.0 мкм |
- |
|
Мягкий контакт |
3.0 мкм |
2.0 мкм |
- |
|
Зазор (20 мкм) |
3.5 мкм |
2.5 мкм |
- |
|
Диапазон длин волн |
UV400 350-450 нм |
||
|
Источник экспонирования |
Лампы Hg 350-1000 Вт (опционно 5000 Вт) |
||
|
Равномерность интенсивности |
< 3.5% (150 мм) |
||
|
Методы совмещения |
|||
|
Совмещение сверху (TSA) |
Точность < 0.5 мкм (совмещение с подсказками или рекомендованными метками пластин) |
||
|
Совмещение снизу (BSA) |
точность < 1.0 мкм |
||
|
Диапазон фокусировки при TSA |
1– 400 мкм (AL400 – фокус с приводом и захват изображения) |
||
|
Точность установки сращивания |
2 мкм |
||
|
Станина совмещения |
|||
|
Диапазон перемещения MA |
X: ± 5 мм |
||
|
Диапазон перемещения BA |
X: ± 3 мм |
||
|
Разрешение |
0.1 мкм |
||
|
Микроскоп TSA |
|||
|
Диапазон перемещения |
X: 33 – 202 мм |
||
|
Микроскоп BSA |
|||
|
Диапазон перемещения |
X: 20 – 210 мм |
||
|
Графический интерфейс пользователя |
|||
|
Windows XP |
|||
|
Неограниченное хранилище рецептов |
|||
|
Удаленный доступ |
|||
|
Коммуникации |
|||
|
Вакуум |
<– 0.8 кПа |
||
|
Сжатый воздух |
0.6 - 0.8 МПа |
||
|
Азот |
> 0.5 МПа |
||
|
Требования к питанию |
|||
|
Питание |
напряжение AC 230 В ± 10 % |
||
|
Размеры |
|||
|
Ширина х глубина |
1350 x 1000 мм = 1.35 м2 |
||
|
Высота |
1803 мм |
||
|
Вес |
~ 750 кг |
||
|
Безопасность оператора и эргономичность |
|||
|
Сертификат SEMI S2 |
|||
|
Сертификат SEMI S8 |
|||
|
ЭМС |
|||
|
Соответствует стандартам СЕ |
|||
* Доступное разрешение зависит от качества контакта, типа оптики, размера пластины, плоскостности пластины, типа резиста, класса чистой комнаты и поэтому может разниться в зависимости от процесса (толщина резиста 1 мкм, линии и пробелы)
|
Равномерность УФ-излучения |
|||
|
|
Средняя интенсивность |
Размер пластины |
|
|
|
|
6" |
< 4" |
|
i-линия* |
40 мВт/см2 |
3.0 % |
2.0 % |
|
Широкий спектр** |
60 мВт/см2 |
3.0 % |
2.0 % |
|
* измерено щупом 365 нм ** измерено широкополосным зондом |
|||
